|
|
| MAXIS锡球整平机 NEW |
 |
·高公斤数(~8000kg)
·压头大size(~□110mm)
·压头高精度 3um
·高精度tray设计 ±200um
·产品种类丰富FC-CSP/FC-BGA(TITO高精度机型,CSP/BGA兼容机型等)
|
压平流程
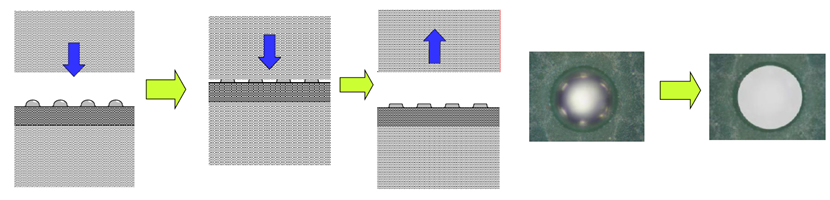
锡球压平目的
·增大die和substrate锡球接着面,减少球面滑坡
·提高助焊剂附着率

|
压平机 BGA Unit type
| 项目 |
基本规格 |
| 衬底TYPE |
UNIT BGA type |
| 对应基板SIZE |
□14mm~□100mm |
| 对应基板厚度 |
MIN 0.15mm~2.5mm
|
| 衬底CLAMP AREA |
距离底板端面1mm |
| 允许PRESS AREA |
距离基板端面3mm以上 |
| WORK供应的排放系统 |
JEDEC TRAY→HIGH ACCURACY ALMI TRAY→JEDEC TRAY |
| 应用PUNCH SIZE |
□10mm~□100mm |
| 上下PUNCH平坦度 |
Max.6um(70×70以下)Max10 um(100× 100以下) |
| PRESS压头数量 |
5轴 |
| press公斤数 |
50kg ~ 4,000kg |
| PRESS荷重精度 |
149kg以下设定值土2kg 150kg以上为土1.5%(内置Servo press的Load cell) |
| 压头温度范围 |
30° ~200" |
| 压头表面温度精度 |
土5% |
压平机 BGA MP type
| 项目 |
基本规格 |
| 衬底TYPE |
QUARTER type |
| 对应基板SIZE |
X方向200mm-300mm,Y方向246.3mm |
| 对应基板厚度 |
MIN 0.15mm ~ 2.5mm
|
| 衬底CLAMP AREA |
距离底板端面3mm |
| 尤许PRESS AREA |
距基板端面6mm或更大 |
| WORK供给和排出系统 |
MAGAZINE H:144mm W:254mm L:210mm~310mm |
| 基板位置确定系统 |
3轴通用XYz位置确定Stage |
| 定位Accuracy |
±0.2mm(标准PLATE) |
| 应用PUNCH SIZE |
□30mm~□100mm |
| 上下PUNCH平坦度 |
Max.6 um(70x70或更少)Max10um(100x 100或更少) |
| PRESS计数 |
3轴 |
| 预载荷 |
100kg ~ 3,000kg |
| PRESS载荷Accuracy |
149kg以下设定值±2kg 150kg以上为±1.5%(内置Servo press的Load cell) |
| 温度范围 |
80℃ ~ 200℃ |
| PUNCH表面温度Accuracy |
设定值±2%以内(设备安装温度传感器 |
|
|
 沪公网安备 31010502005662号
沪公网安备 31010502005662号